
IC封装基板国产化替代进程正在提速。作者 | ZeR0编辑 | 漠影芯东西12月29日报道,12月27日,深圳和美精艺半导体科技股份有限公司(简称“和美精艺”)科创板IPO获受理。
和美精艺成立于2007年,专注于IC封装基板领域,是内资厂商中少数几家全面掌握自主可控IC封装基板大规模量产技术的企业,2022年被认定为国家级专精特新“小巨人”企业。IC封装基板是芯片封装环节的核心材料,为芯片提供支撑、散热和保护作用,同时为芯片与PCB之间提供电子连接,起着“承上启下”的作用,甚至可埋入无源、有源器件以实现一定系统功能。其产能、品质、交期等,都直接影响到下游客户制造芯片的性能、良率与效率。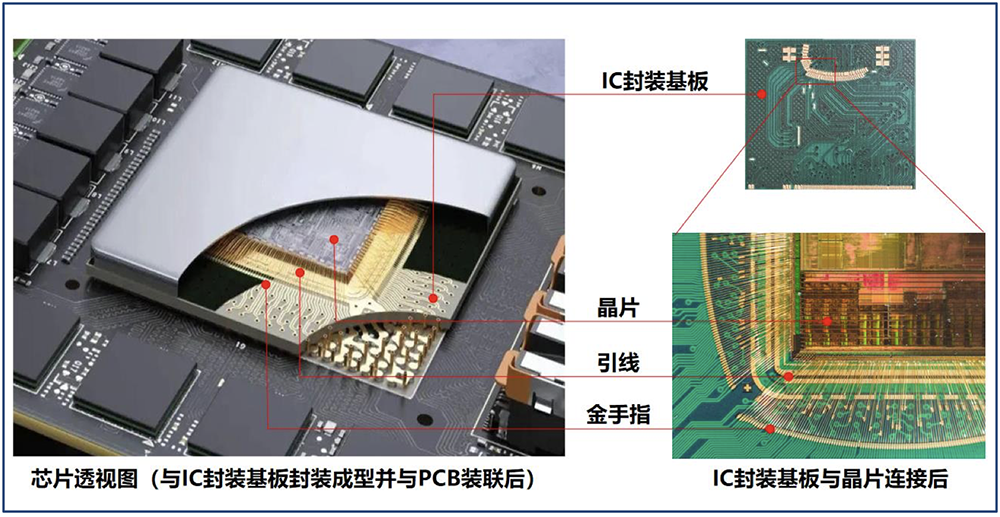
在自主可控IC封装基板研发与产业化领域,和美精艺已有超过15年的持续积累与沉淀。从2020年至2023年上半年,其累计营收达9.17亿元,累计净利润达1亿元。本次募投项目,和美精艺拟募资8亿元,用于珠海富山IC载板生产基地建设项目(一期)和补充流动资金,将通过引进更加先进的显影、曝光、蚀刻、成型、检测等设备,提高IC封装基板生产和检测过程的精度,实现更高制程技术的突破。
01.三年半收入超9亿,已进入快速发展“赶超期”
从2007年成立起,和美精艺的发展经历了4个阶段,其产品主要应用于存储芯片领域。
2020年至今,随着江门生产基地投产,mSAP制程实现量产,成功布局中高端存储芯片封装基板,和美精艺正式进入快速发展的“赶超期”。
过去三年,和美精艺的年收入连年增长,但研发费用占同年收入比例较低,每年均不到10%。
其存储芯片封装基板的收入、主营业务毛利占比在过去三年半均超过9成。
报告期内,和美精艺与同行业可比上市公司在封装基板领域的毛利率对比如下:
和美精艺的主要产品是存储芯片封装基板,也生产少部分非存储芯片封装基板,如逻辑芯片、通信芯片、传感器芯片的封装基板等。
下图中黄色代表和美精艺拥有的产品:
和美精艺主要产品结构图如下所示: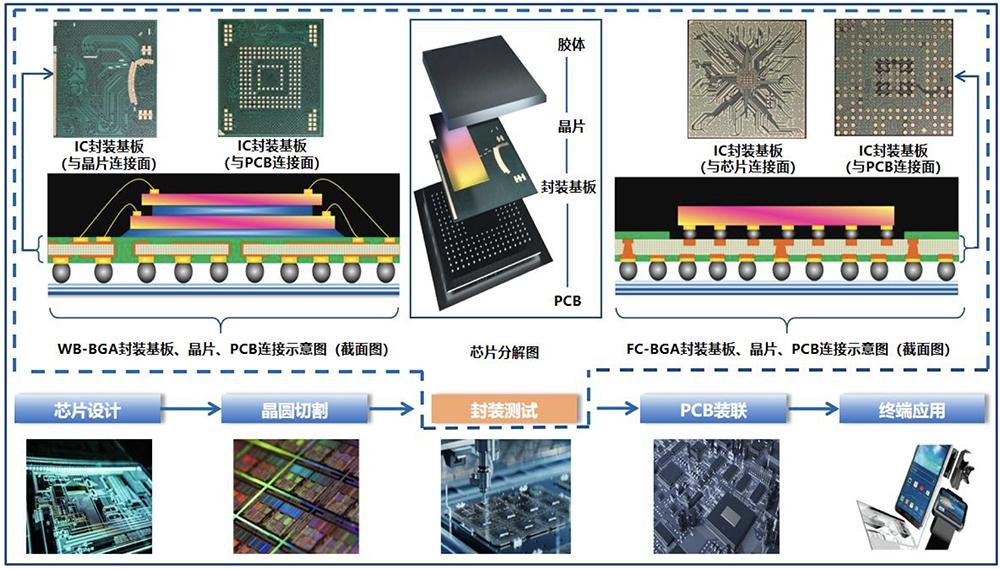
其IC封装基板经过封装以后,广泛应用于智能手机、平板电脑、PC、智能穿戴设备、数据服务器、汽车电子等终端领域。
02.国内核心封装基板企业,主要生产BT封装基板
据中国台湾电路板协会统计,2022年全球前十大封装基板供应商及市占率如图所示,欣兴电子(17.7%)、南亚电路(10.3%)、揖斐电(9.7%)位居全球前三。
目前,世界领先厂商以制造FC-BGA封装基板、ABF封装基板等高附加值产品为主。其中,全球BT封装基板前五大厂商分别为LG Innotek、三星电机、信泰电子、景硕科技、欣兴电子;全球ABF封装基板前五大厂商分别为欣兴电子、揖斐电、南亚电路、新光电气、AT&S。内资厂的产品普遍以WB-CSP/BGA封装基板、FC-CSP封装基板、BT封装基板为主,产品附加值相对较低,与国际一流厂商在高端芯片封装基板领域存在较大差距。根据中信证券研究部的研报数据,引线键合(WB)封装基板在芯片封装总成本(不含晶片成本)中占比约为40%-50%,而高端的倒装(FC)封装基板在芯片封装总成本(不含晶片成本)中则更高,占比约为70%-80%。包括和美精艺在内,中国大陆内资企业主要生产BT封装基板,占全球BT封装基板产值约7%,高端逻辑芯片使用的ABF封装基板尚未形成大规模产业化能力。
境内内资企业中,深南电路、兴森科技、和美精艺2022年IC封装基板业务产值分别为25.20亿元、6.90亿元、3.10亿元。
03.技术工艺先进,研发人员占比超过13%
和美精艺在报告期内积极布局FC-BGA封装基板产品的技术研发,通过使用国产高性能PP材料和自主可控的工艺制程生产四层FC-BGA封装基板(线宽/线距18/18μm)样品,目前终端客户正在对相关产品进行综合验证。其IC封装基板的生产主要有两种工艺制程方式:Tenting(减成法)制程和mSAP(改良型半加成法)制程。IC封装基板具有高密度、高精度、高性能、小型化及薄型化等特点,与晶片、引线等经过封装测试后共同组成芯片。其最具代表性的通用指标为:线宽/线距、手指中心间距,这两项参数也充分体现了生产企业的核心制程能力。线路层数、板厚等也通常作为产品通用指标进行列示。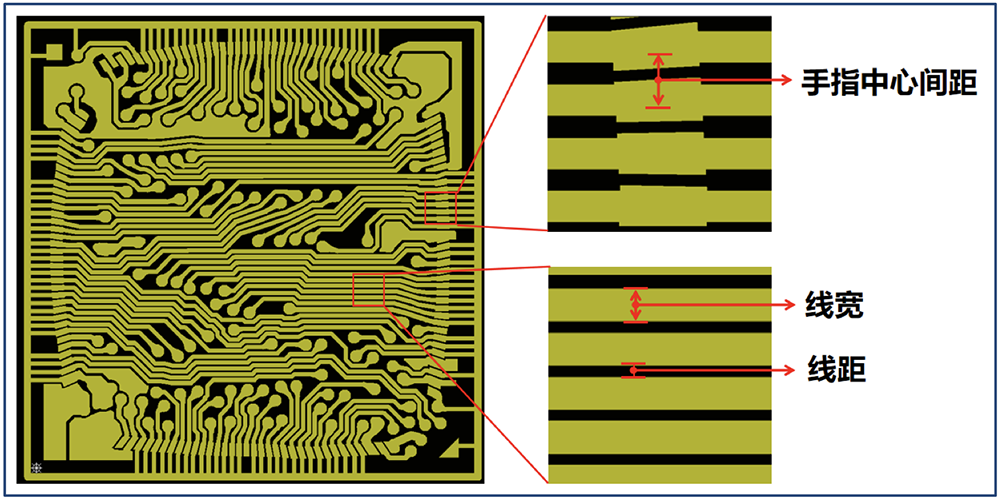
此外,量产制程能力和样品制程能力同样为考验行业企业技术水平的重要指标。
相较于普通PCB,IC封装基板在线宽/线距、板厚、制备工艺等多项技术参数上都要求更高。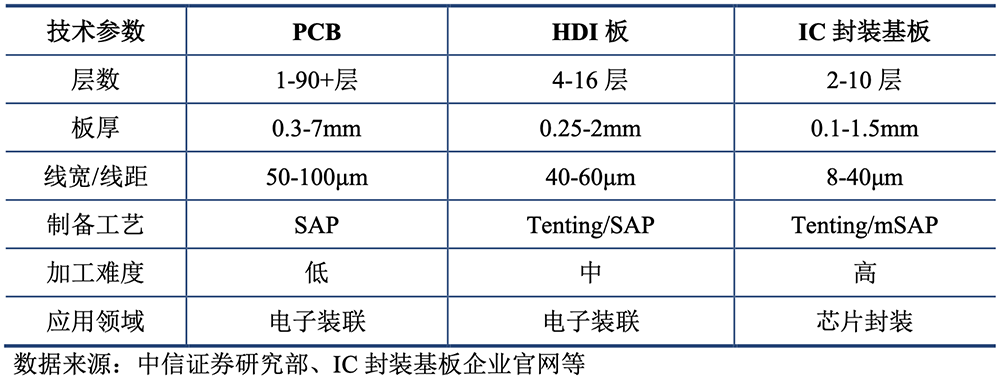
PCB板线宽/线距通常在50-100μm,板厚通常在0.3-7mm,无法满足芯片封装的技术要求;HDI板线宽/线距通常在40-60μm,板厚通常在0.25-2mm;IC封装基板线宽/线距在8-40μm,板厚在0.1-1.5mm。根据基板基材、封装工艺的不同,IC封装基板的核心性能参数及下游应用领域也存在较大差异,具体情况如下: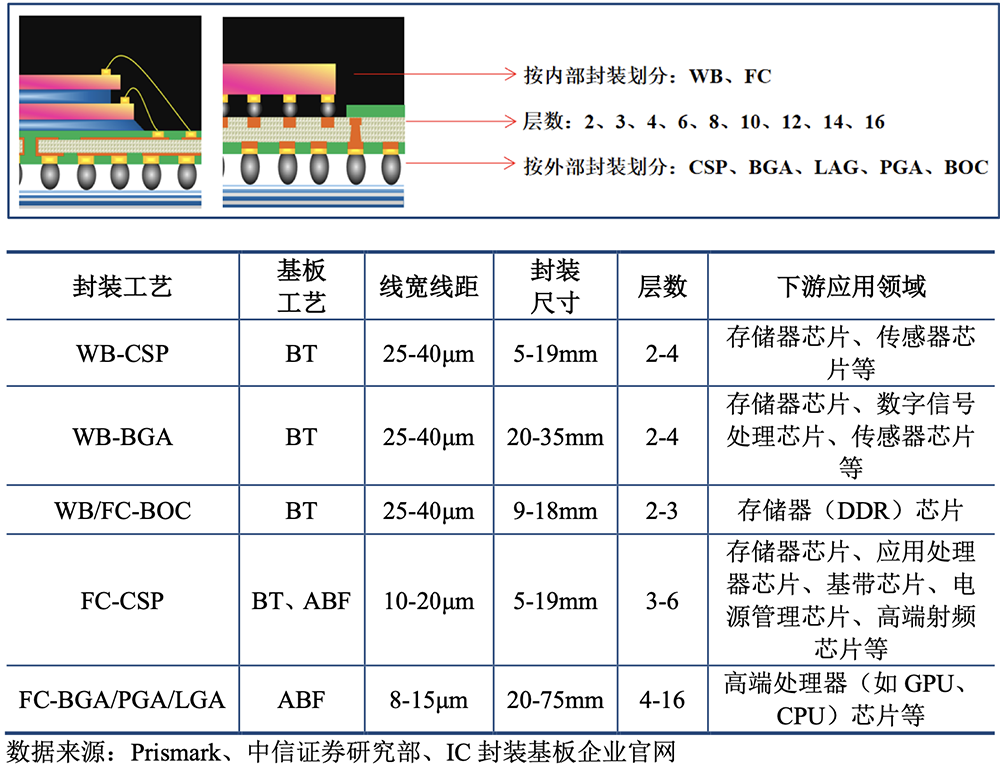
目前,和美精艺Tenting制程工艺能够实现线宽/线距30/30μm封装基板产品的大规模量产,样品能力达到线宽/线距25/25μm。其mSAP制程工艺能够实现线宽/线距20/20μm封装基板产品的大规模量产,样品能力达到线宽/线距15/15μm。通过对比三星电机、深南电路、兴森科技三家境内外主要IC封装基板企业公开披露的产品参数,和美精艺存储芯片封装基板产品和技术工艺水平与境内外主要厂商保持一致,具备先进性。
截至2023年6月30日,和美精艺共有在册员工534人,拥有各类研发人员共73人,占其员工总人数比例为13.67%。其核心技术人员共计4人,分别为居永明、何福权、张元敏及廖志云。
04.前五大客户收入占比过半
和美精艺通过向客户销售IC封装基板产品获得相应的收入,扣除成本、费用等相关支出,形成公司的盈利。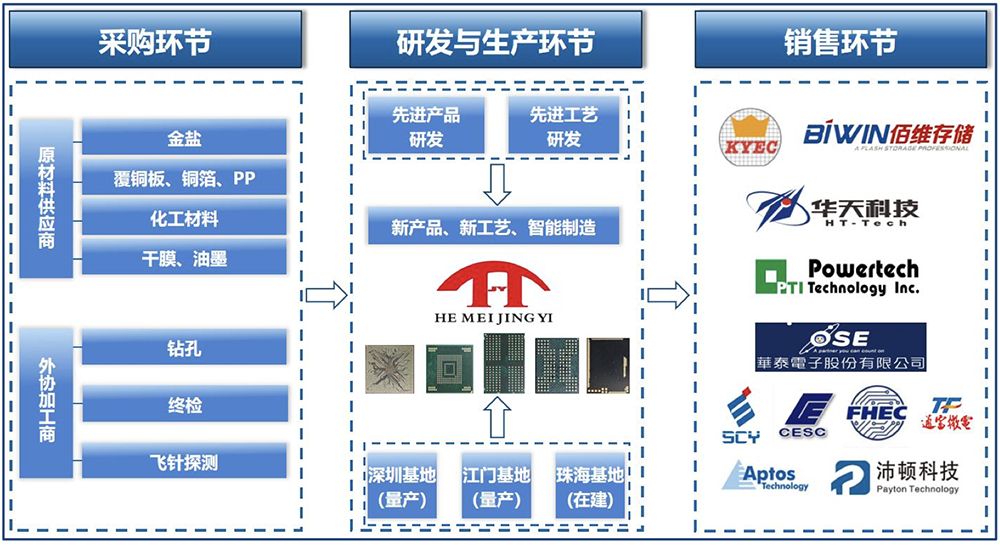
其优质IC封装基板产品的客户包括京元电子、力成科技、华天科技、通富微电、华泰电子、甬矽电子等封测大厂及佰维存储、时创意等存储芯片企业。部分客户如下:
报告期内,和美精艺前五大客户产生的收入占主营业务收入的比例分别为56.73%、53.53%、47.30%、48.02%。
IC封装基板的主要原材料为金盐和覆铜板,其占其主营业务成本的比例较高。报告期内,原材料占和美精艺主营业务成本的比例分别为61.25%、52.53%、51.46%、47.95%。和美精艺向前五大供应商采购金额合计分别为0.63亿元、0.95亿元、0.93亿元、0.38亿元,占当期采购总额的比例分别为61.38%、58.55%、58.78%、52.15%。
和美精艺曾通过全资子公司江西和美间接持有吉展精密30.00%的股份,江西和美已于2020年1月9日将其所持有的吉展精密股份全部对外转让,和美精艺与其他前五名供应商之间不存在关联关系,其董事、监事、高级管理人员、核心技术人员、持有发行人5%股份以上的股东、公司的其他关联方未在上述供应商中拥有权益。
05.高新投、深创投参投
截至招股书签署日,和美精艺的股权结构如下:
和美精艺的国有股东为高新投、深创投,没有外资持股,近一年也没有新增股东。其股东中,格金广发、格金三号与格力集团有一定关联。格力集团持有格金广发43.8%的财产 份额;格力集团间接持有格金三号的执行事务合伙人格力投资100%股权;紫杏共盈的合伙人杨涛担任格力集团全资子公司珠海格力金融投资管理有限公司的董事、经理。和美精艺的控股股东、实际控制人是其董事长、总经理岳长来,持股27.59%。岳长来通过与朱圣峰、居永明、何福权签署一致行动协议,合计控制公司39.98%的表决权份额。本次发行前,和美精艺前十名股东如下:
除岳长来外,其他持有和美精艺5%以上股份或表决权股东有如下这些:
和美精艺的董事、监事、高级管理人员及核心技术人员最近一年从和美精艺及关联企业领取薪酬的情况如下:
06.结语:IC封装基板国产化替代进程正在提速
近年来,受消费电子、云计算、汽车电子飞速发展的影响,全球半导体集成电路行业呈现稳步上升趋势,未来AI、工业智能、智能驾驶等因素将会促进芯片需求量的持续增长。在芯片封测领域,中国内资封测企业占据了全球近30%的市场份额。但在IC封装基板领域,中国内资企业仅占全球市场份额的3.2%,其中占BT封装基板全球市场份额的7%,ABF封装基板尚未形成大规模国产化能力。尽管近年来中国大陆IC封装基板行业产值已经逐步提升,但与日本、韩国、中国台湾等地区相比,中国内资企业技术水平仍存在较大差距。IC封装基板与芯片封装测试较大的国产化率差异,将会加速IC封装基板国产化替代进程。进一步扩大产能、提高品牌知名度等措施,将是这些内资企业进一步提高市场占有率的必经之路。
 芯圈IPO
芯圈IPO
深度追踪国内半导体企业IPO;在国产替代的东风下,一批优秀的国内半导体公司正奔赴资本市场借势发展。 作 者
作 者

*博客内容为网友个人发布,仅代表博主个人观点,如有侵权请联系工作人员删除。


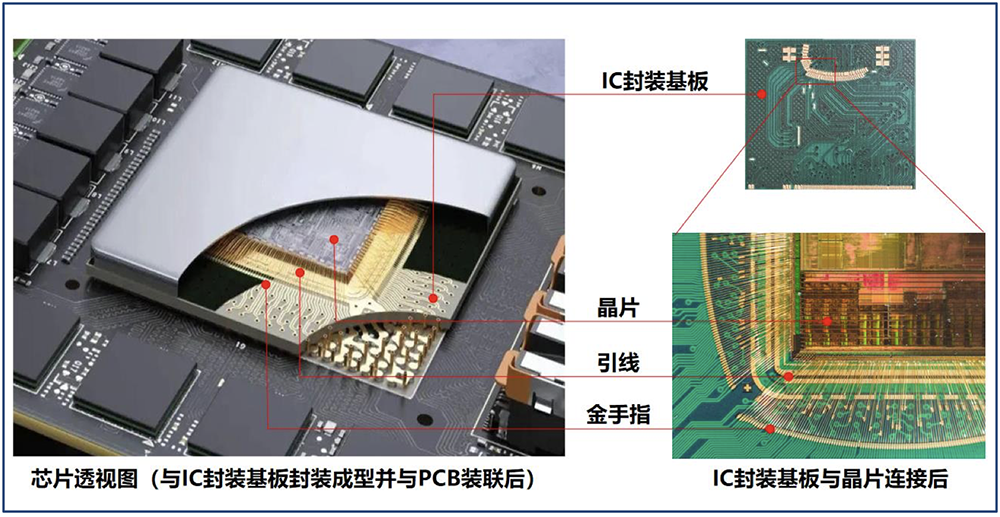








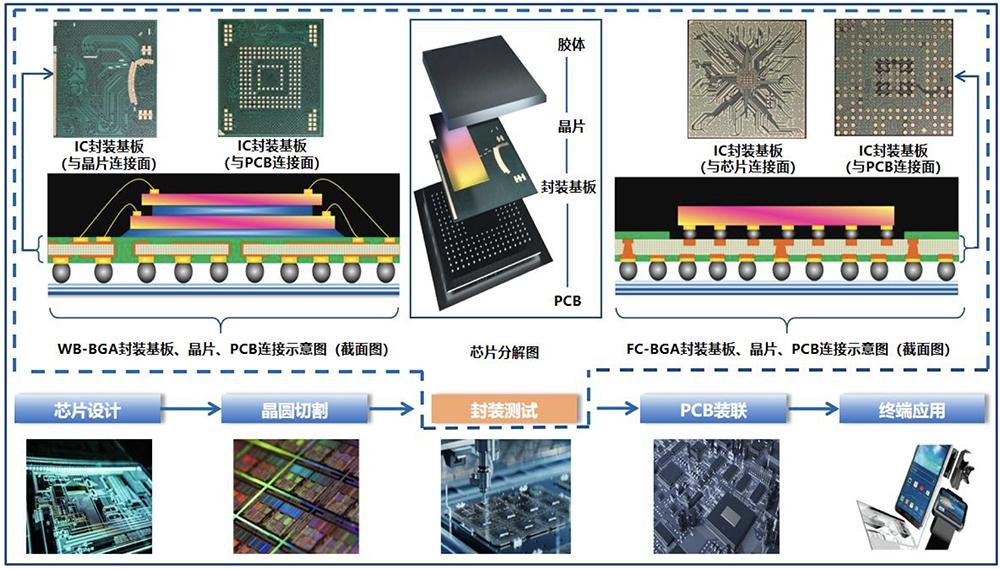




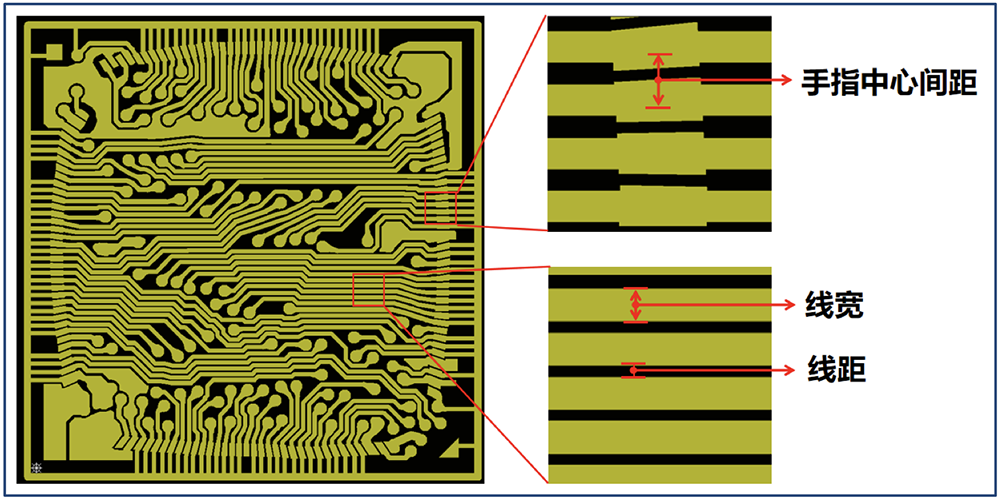

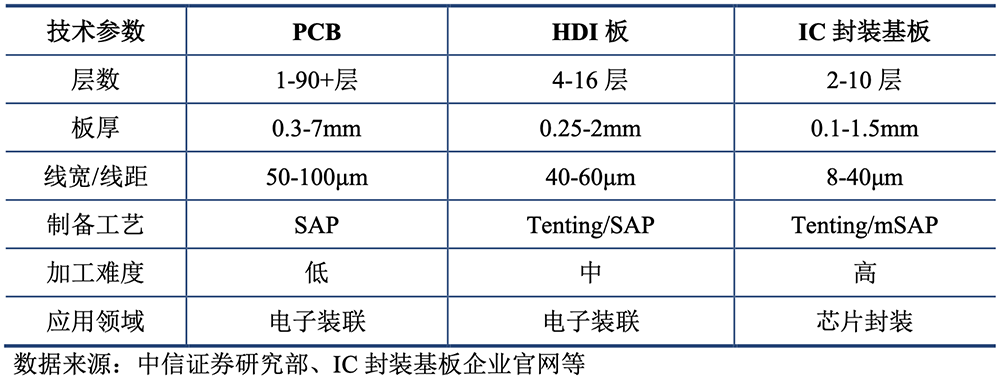
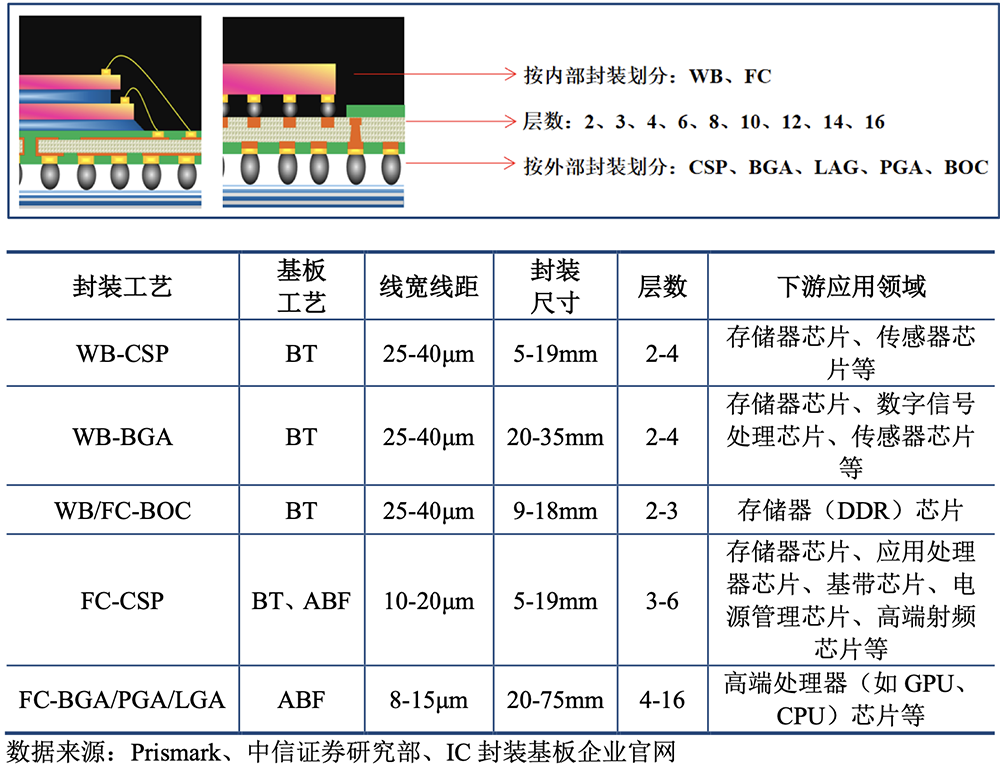


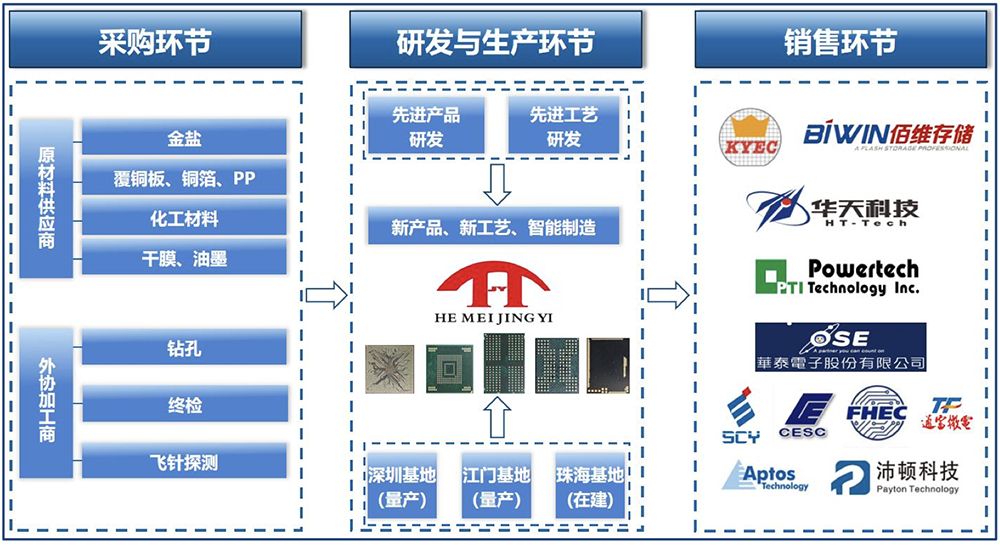








 芯圈IPO
芯圈IPO 作 者
作 者